後道工序
外觀
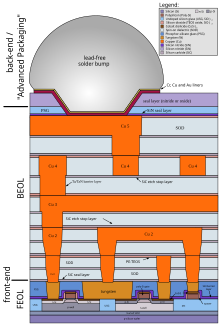

後道工序(back end of line,BEOL)是IC製造的第二部分,其中各個器件(晶體管、電容器、電阻器等)與晶圓上的布線(金屬化層)互連。常見的金屬有銅和鋁。 [1]BEOL通常在晶圓上沉積第一層金屬時開始。BEOL包括觸點、絕緣層(電介質)、金屬層以及用於芯片與封裝連接的接合位點。
在最後一個FEOL步驟之後,就會出現一個帶有隔離晶體管(沒有任何電線)的晶圓。在製造階段的BEOL部分中,形成接觸(焊盤)、互連線、通孔和介電結構。對於現代IC工藝,可以在BEOL中添加 10 多個金屬層。
BEOL 步驟:
- 源極和漏極區域以及多晶硅區域的硅化。
- 添加電介質(第一層,下層是預金屬電介質(PMD) – 將金屬與硅和多晶硅隔離,對其進行CMP處理
- 在 PMD 上打孔,並在其中建立接觸點。
- 添加金屬層1
- 添加第二個電介質,稱為金屬間電介質(IMD)
- 通過電介質製作通孔以將較低金屬與較高金屬連接。通過金屬CVD工藝填充通孔。
- 重複步驟 4-6 以獲取所有金屬層。
- 添加最終鈍化層以保護微芯片
1998 年之前,幾乎所有芯片都使用鋁作為金屬互連層。 [2]
BEOL 之後有一個「後段製程」,該工藝不是在潔淨室中完成的,通常由不同的公司完成。它包括晶圓測試、晶圓背面研磨、芯片分離、芯片測試、 IC封裝和最終測試。
相關[編輯]
參考[編輯]
- ^ Karen A. Reinhardt and Werner Kern. Handbook of Silicon Wafer Cleaning Technology 2nd. William Andrew. 2008: 202. ISBN 978-0-8155-1554-8.
- ^ Copper Interconnect Architecture.
進一步閱讀[編輯]
- Chapter 11: Back End Technology
 . Prentice Hall. 2000: 681–786. ISBN 0-13-085037-3.
. Prentice Hall. 2000: 681–786. ISBN 0-13-085037-3. - Chapter 7.2.2: CMOS Process Integration: Backend-of-the-line Integration. Wiley-IEEE. 2010: 199–208 [177–79]. ISBN 978-0-470-88132-3.
